
<b id="0toem"><menuitem id="0toem"></menuitem></b>
<code id="0toem"><abbr id="0toem"></abbr></code>
<code id="0toem"></code>

德國亞琛工業(yè)大學在氮化鎵(GaN)外延結(jié)構(gòu)中首次實現(xiàn)了垂直溝道結(jié)型場效應晶體管(vc-JFET)。
垂直器件對于高功率密度應用是很有應用價值的,因為通過該結(jié)構(gòu)將峰值電場從表面推入散裝材料,從而避免了對表面鈍化或場板的需要。
研究人員使用低成本的2英寸藍寶石襯底通過MOCVD生成準垂直vc-JFET。之后使用重n型摻雜GaN層實現(xiàn)背面“虛擬”接觸(圖1)。真正的垂直器件會使漏極觸點穿過晶圓的背面 - 這是使用絕緣藍寶石無法實現(xiàn)的。
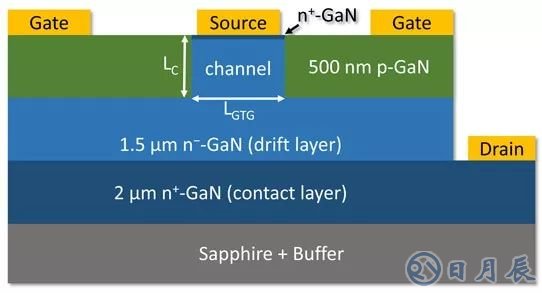
圖1:具有選擇性再生長的p-GaN柵極區(qū)域的準垂直vc-JFET的示意圖。
在大多數(shù)垂直器件的研究中,會選擇使用更昂貴的獨立式或塊狀GaN,形成真正的垂直結(jié)構(gòu)。但在實際生產(chǎn)中,成本是一個關(guān)鍵考慮因素,真正的垂直器件將有幾種可能的生成途徑 ——不使用襯底或使用導電生長襯底,例如獨立式或塊狀GaN或硅。但使用硅則會導致材料質(zhì)量低,從而泄漏電流越大。
通過首先施加2μm輕摻雜n-GaN漂移層和20nm重摻雜n-GaN接觸層來生長RWTH器件結(jié)構(gòu),然后使用二氧化硅作為在掩模和MOCVD期間保護溝道的硬掩模,在重摻雜p-GaN的選擇性區(qū)域再生長。其中柵極 - 柵極(GTG)距離為4μm。通道寬度為54μm。
用于選擇性區(qū)域再生的刻蝕使用干法和濕法的組合方法。溝道的側(cè)壁與GaN晶體結(jié)構(gòu)的m面對準,以減少干刻蝕的粗糙度。濕四甲基氫氧化銨(TMAH)處理進一步使側(cè)壁變平并從蝕刻底部的c面表面去除蝕刻損傷。在p-GaN再生長之后,通過在氮氣中在900℃下退火900秒來激活材料。退火的目的是從鎂摻雜中除去氫。氫 - 鎂絡合物干擾p-GaN材料中所需的空穴的產(chǎn)生。
該器件的金屬化由用于漏極和源極的鈦/鋁/鎳/金和用于p-GaN柵極的鎳/金組成。首先沉積漏電極,然后是柵極,最后是源極。漏電極和柵電極分別在830℃和535℃下退火。由于p-GaN接觸的溫度限制,源電極未退火。
漏極觸點為歐姆,接觸電阻為0.8Ω-mm。然而,柵極接觸是非線性的,在零偏壓下具有900Ω-mm的接觸電阻,而源極表現(xiàn)出肖特基行為。這些問題與源極接觸的非退火性質(zhì)和在柵極下面不存在重摻雜的p-GaN層有關(guān)。
柵電極允許調(diào)制pn結(jié)處的耗盡層的厚度,阻斷源極和漏極之間的溝道區(qū)域中的電流。漂移層具有“中等”厚度,降低了預期的擊穿性能。中等漂移層的目的是通過干刻蝕過程更容易接近虛擬背接觸。
鑒于類似肖特基的“源極”接觸,研究人員決定逆轉(zhuǎn)漏極偏置,因此器件的操作就好像源是漏極一樣,反之亦然。包括肖特基導通電壓約0.5V的器件的行為延遲了漏極偏置的電流增加。具體的導通電阻為2.36mΩ-cm2,歸一化為溝道截面積。 柵極漏電流比漏極電流低兩個數(shù)量級,柵極電位高達10V。
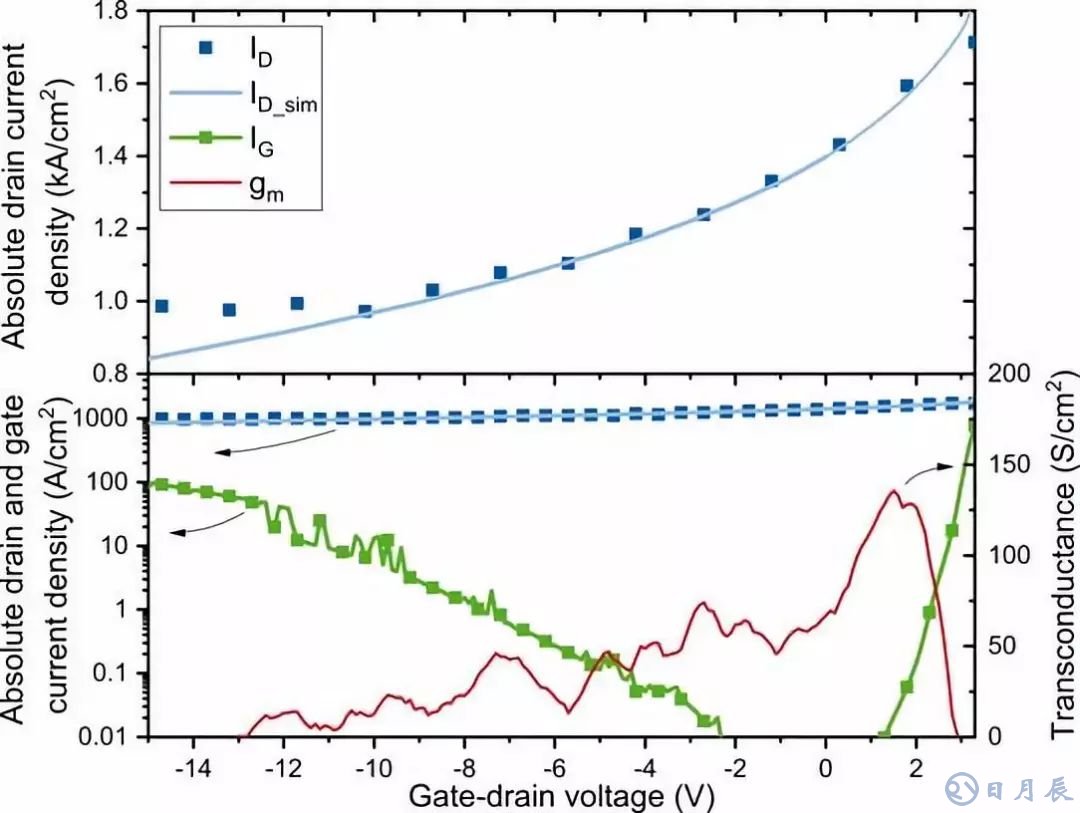
圖2:1V源極 - 漏極偏置下的準垂直vc-JFET的漏極和柵極電流以及跨導,傳輸特性。 標準化為通道橫截面。
雖然晶體管沒有夾斷,但柵極電位確實調(diào)制了漏極電流(高達1.8倍,柵極為-10V,圖2)。根據(jù)模擬,夾斷發(fā)生在-112V左右。將其放在一位數(shù)范圍內(nèi)需要縮小尺寸,同時減少溝道摻雜以增加空間電荷區(qū)域的范圍。模擬結(jié)果表明,在-12V時,空間電荷區(qū)域僅從4μm柵極 - 柵極間隙的兩側(cè)延伸1μm。
模擬還表明,常關(guān)增強模式操作將會產(chǎn)生1μm的柵極 - 柵極間距,以及5μm溝道長和5x10E15·cm-3摻雜,提供+2.3V閾值。根據(jù)汞電容 - 電壓分布測量,實驗裝置的漂移/溝道摻雜為1×10E16·cm-3。
<b id="0toem"><menuitem id="0toem"></menuitem></b>
<code id="0toem"><abbr id="0toem"></abbr></code>
<code id="0toem"></code>