
<b id="0toem"><menuitem id="0toem"></menuitem></b>
<code id="0toem"><abbr id="0toem"></abbr></code>
<code id="0toem"></code>

集成電路封裝作為集成電路產(chǎn)業(yè)鏈中不可或缺的環(huán)節(jié),一直伴隨著集成電路芯片技術(shù)的不斷發(fā)展而變化。傳統(tǒng)上,封裝的作用包含對芯片的支撐與機(jī)械保護(hù),電信號的互連與引出,電源的分配和熱管理。
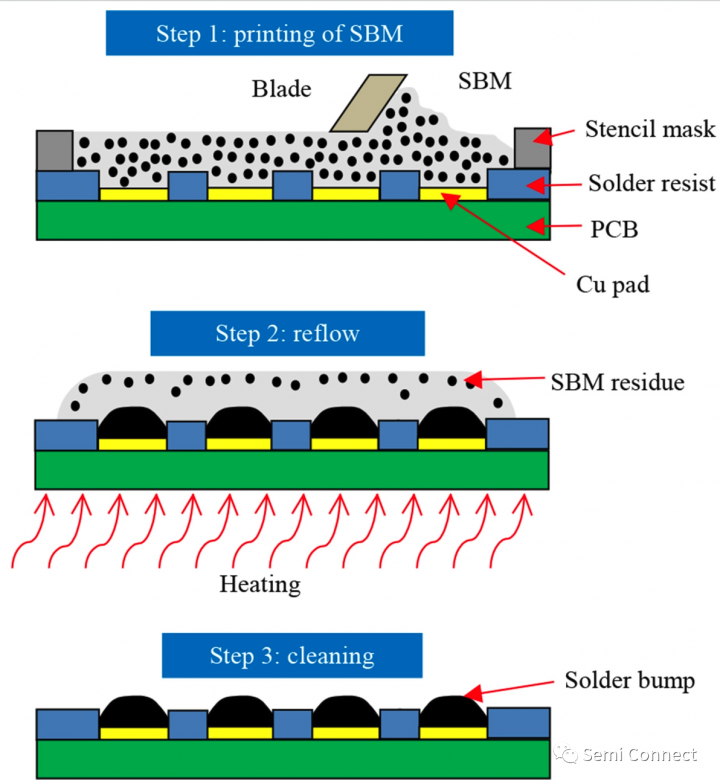
隨著芯片技術(shù)的發(fā)展,封裝具有了新的作用,如功能集成和系統(tǒng)測試。從封裝類型的發(fā)展來看,早期的封裝主要是金屬晶體管外形 (Transistor Out-line, TO)封裝和陶瓷雙列直插封裝(CeramicDual In-line Package, CDIP),它們都屬于通孔插裝型(Pin ThroughHole, PTH) 的封裝形式。隨著集成電路芯片技術(shù)的進(jìn)步,對封裝密度提出了越來越高的要求,這就導(dǎo)致了越來越多封裝形式的出現(xiàn)。從20世紀(jì)90年代初期開始,雙列直插的通孔插裝型封裝逐漸轉(zhuǎn)向了適應(yīng)于表面貼裝的封裝形式,典型的形式包括小外形封裝(Small Outline Package, SOP )、四面引線扁平封裝(Quad Flat Package, QFP)、球柵陣列 (Ball Crid Aray, BGA)封裝等。
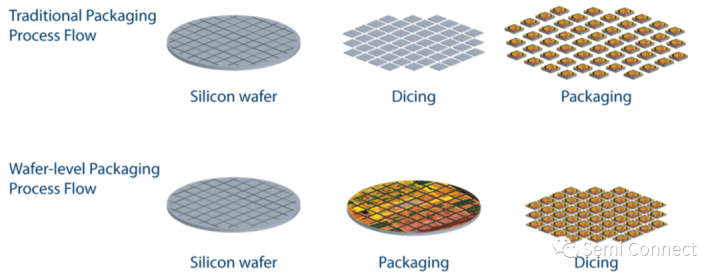
隨著技術(shù)的進(jìn)一步發(fā)展,圓片級封裝 ( Wafer Level Package, WLP)、三維封裝 (Three Dimension Package, 3DP)和系統(tǒng)級封裝 (Systemin Package, SiP) 等形式相繼出現(xiàn),封裝形式與封裝技術(shù)之間在名稱上的區(qū)分也越來越模糊。按照芯片到封裝體之間的互連方法劃分,目前通常有引線鍵合 ( Wire Bonding, WB)、載帶自動(dòng)鍵合 (Tape Autorated Bonding, TAB)、倒裝芯片 (Flip Chip, FC) 和硅通孔(Through silicon Via, TSV)技術(shù)等。 傳統(tǒng)的封裝形式主要是利用引線框架作為載體,采用引線鍵合互連的形式(如DIP、SOP 和QFP 等);之后出現(xiàn)了采用引線鍵合互連并利用封裝基板來實(shí)現(xiàn)(如 BGA、LGA 等)的封裝形式,并逐漸采用在封裝基板上的倒裝芯片實(shí)現(xiàn)(如 FC-BGA 等)。
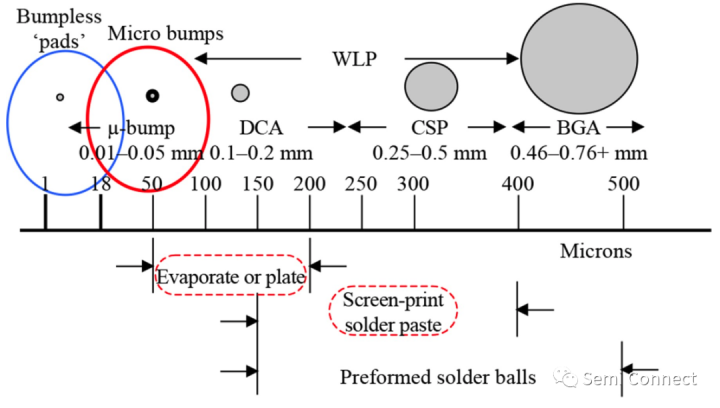
國際半導(dǎo)體技術(shù)路線圖(ITRS)曾經(jīng)明確提出了未來集成電路技術(shù)發(fā)展的兩個(gè)方向:一是 More Moore,即延續(xù)摩爾定律;二是 More than Moore,即拓展摩爾定律。沿著拓展摩爾定律方向發(fā)展的技術(shù)路線,更關(guān)注將多種功能芯片集成在一個(gè)系統(tǒng)中,包括信息處理芯片(如處理器、存儲(chǔ)器等)和信息交互芯片(如射頻芯片、傳感器等),因此系統(tǒng)級封裝成為了末來封裝技術(shù)和系統(tǒng)集成的主流技術(shù)路線之一。
<b id="0toem"><menuitem id="0toem"></menuitem></b>
<code id="0toem"><abbr id="0toem"></abbr></code>
<code id="0toem"></code>